Benefits and Features
Advanced features and process advantages
- High precision touchdown detection without time delay, e.g. for bonding on very thin substrates
- Optimized pattern recognition: image capture with new digital image processing and flash
- Hesse Assist Tools (option):
- E-Box: patented solution for optimized tool change and
programmable alignment marks for wedge and wire clamp - Automated bondforce calibration; a load cell prevents operater error and ensures robust processes
- Innovative bondtool detection
- E-Box: patented solution for optimized tool change and
- Automated bondtool calibration without wedge gauge
- Loop generator for individualized loops
- Wear-free components with Piezo technology
- Maintenance-free solid state joints
- Pre-setting of bondheads via EEPROM
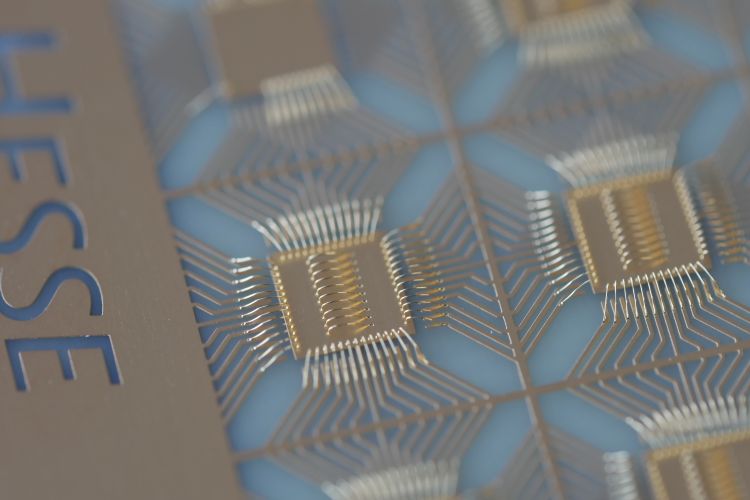
Fine wire (Au) with mit ball-wedge bondhead
Flexibility
- Flexible use of working area, e.g. with a number of bonding stations (manual loading or with indexers)
- Universal software interface for indexer control
- Maximization of throughput by automation with two or more parallel lines
Speed
- Up to 7 wires per second, depending on application and bondhead,
e.g. wedge-wedge bondhead, 25 μm wire, 1 mm loop length, metallized wafer
Quality
- Continuous real time monitoring of wire deformation, transducer current, frequency and impedance within programmable control limits
- Process integrated Quality Control PiQC: detection of further parameters, e.g. friction behavior, by additional sensor system for 100 % quality monitoring in real time (patented); available as an option
Wedge-Wedge bondhead for wire bonder Bondjet BJ855
- Bondhead 45°, 60° and 90° (deep access)
- Freely programmable wire feed, tail length, tear stroke and opening gap of wire clamp
- Precise bondforce control (static and dynamic)
- Bondheads can be replaced in minutes
Ball-Wedge bondhead for wire bonder Bondjet BJ855
- Multi-level bonding according to Z axis stroke of 31 mm
- 11/19 mm capillaries
- Ultrasonic in preferred direction by bondhead rotation
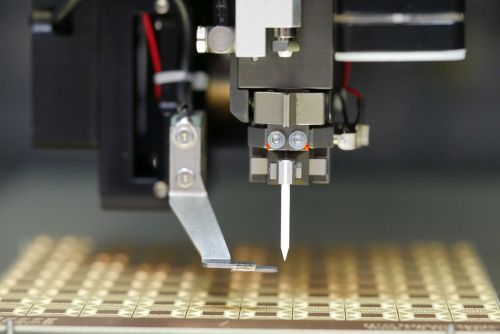
Ball-wedge bondhead for wire bonder BJ855
Technical data
Working area
- X: 305 mm; Y: 410 mm
- Z stroke: 31 mm
- P rotation: 440°
Mechatronic bondhead
- Wedge-wedge bondhead 45°, 60°
- Wedge-wedge bondhead 90° (deep access) for ribbon or wire
- Ball-wedge bondhead
Wire
- Al, Au, Ag, Cu, Pt: 12.5 µm – 75 µm*(0.5 mil – 3 mil)*
Ribbon
- Al, Au: 35 µm x 6 µm up to 250 µm x 25 µm*
(1.4 mil x 0.25 mil up to 10 mil x 1 mil)*
Fine wire loop design
- Loop generator for individualized loops
- Loop form functions: constant wire length, constant loop height, individual loop shapes
- Fine pitch (wedge-wedge): 40 µm inline, 25 µm staggered/dual line (depending on wire diameter and loop)
Footprint and weight
- 740 mm x 1484 mm x 1912 mm (W x D x H , excl. light tower)
- Weight: approx. 1150 kg
* depending on bondhead, application, wire
Video